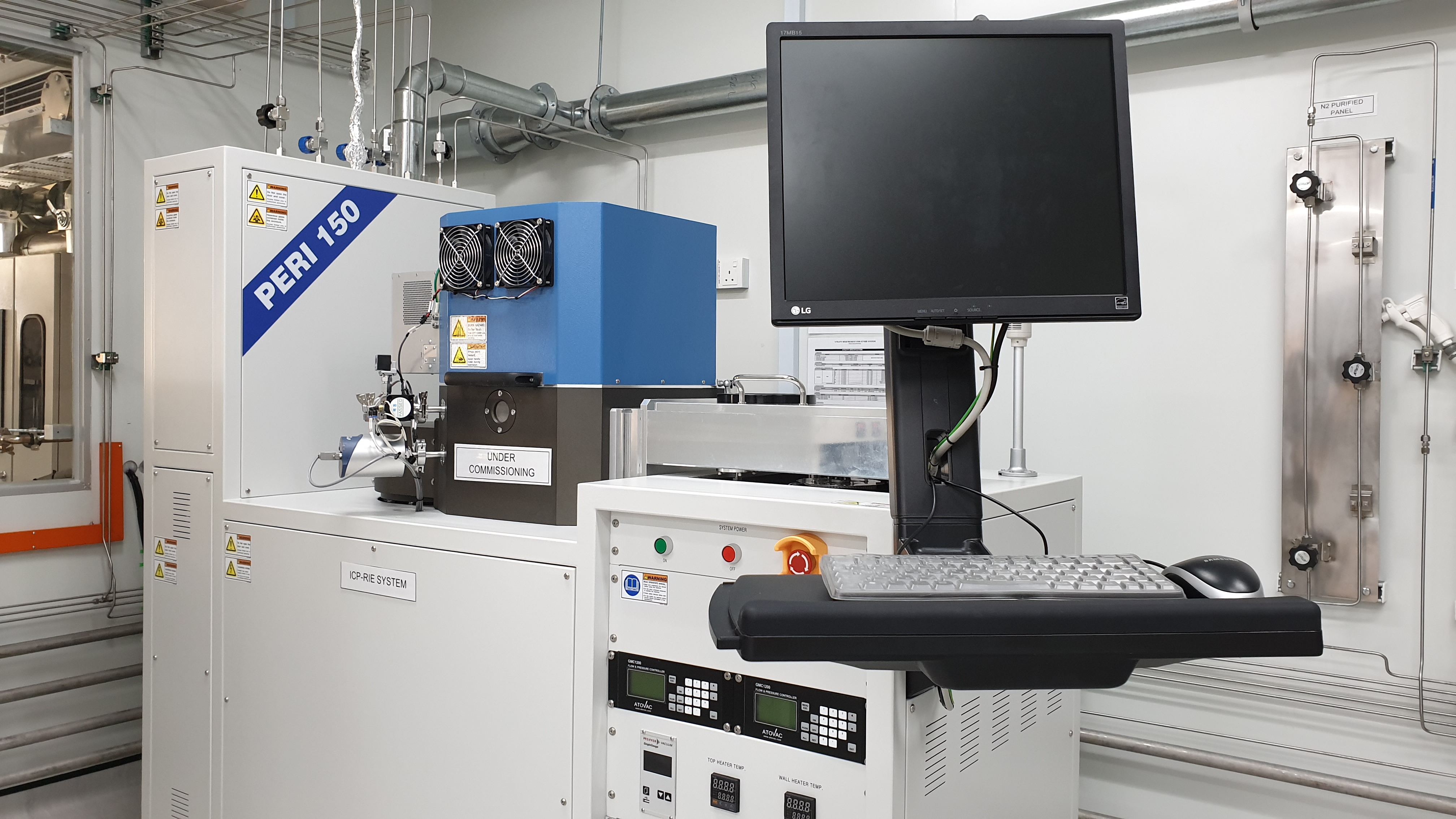


Laboratory Equipment & Services Information System
by Centralized Laboratory Management Office (CeLMO)
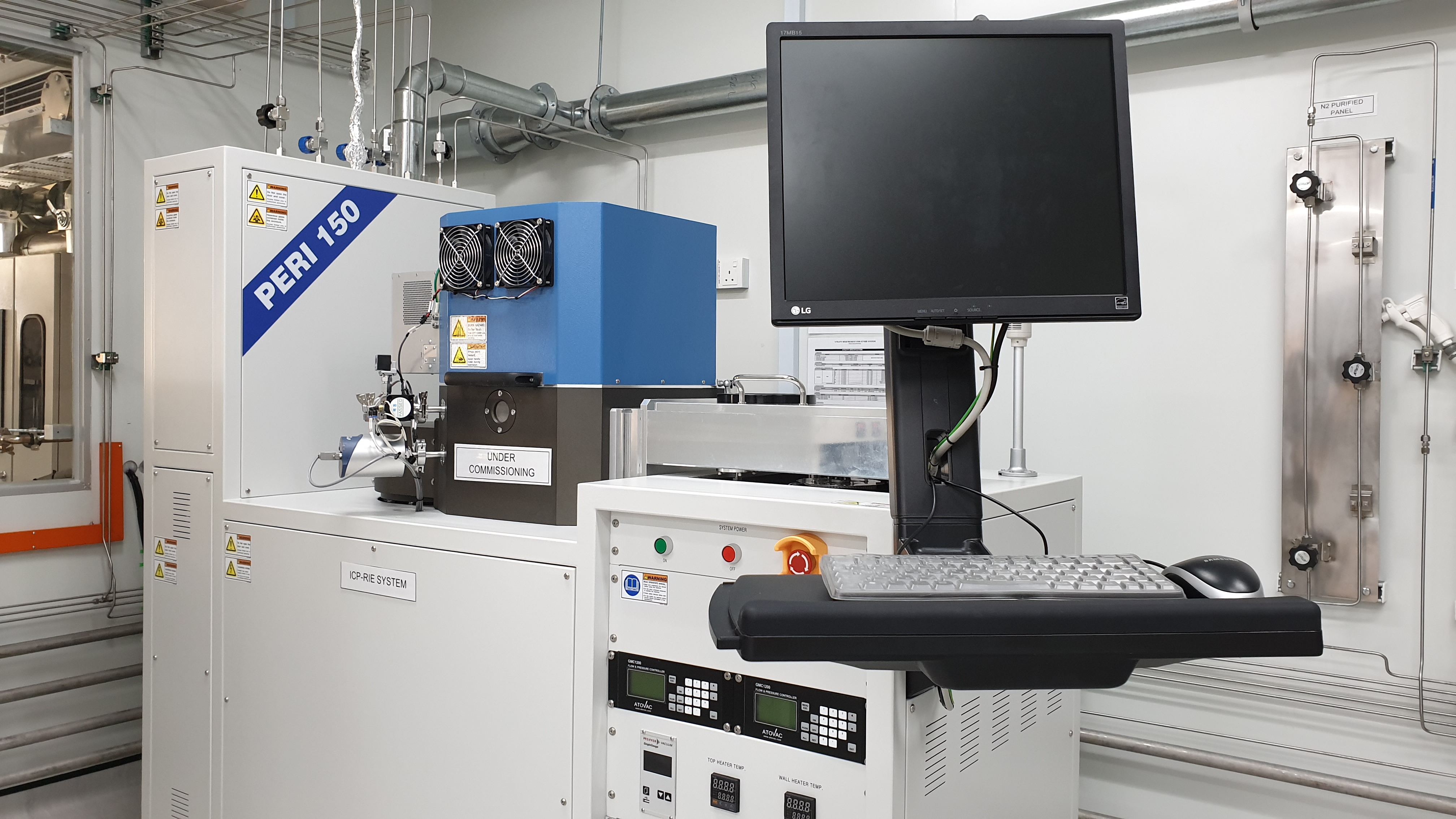
Process 1) Etching material : III-V compound semiconductors 2) Substrate size : Piece, 2 inch, 4 inch 3) Product yield : 1 wafer/run Substrate size & load capacity : Piece, 2 inch, 4inch wafer Source (gas) injection type : Showerhead type Chuck cooling by chiller Mechanical wafer clamp Substrate back side He cooling RF generator 600W 1ea(13.56MHz) for bias RF generator 1,000W 1ea(13.56MHz) for ICP source Rotary pump (fomblin type) + TMP for process chamber Rotary pump for loadlock chamber Baratron Gauge for processing pressure : Full scale 0.1 Torr Process pressure control by pendulum valve PC control SYSTEM FEATURES Process Chamber Module Process chamber – Chamber material : Anodized aluminum – View port with shutter – Wall temperature control – Chamber purge & vent Showerhead unit – Process gas injection through showerhead – Showerhead material : Aluminum ICP source – Uniform plasma density suitable for 4inch wafer processing – ICP cavity wall : Al2O3 – Top plate with a port for plasma diagnostics – Top plate temperature control Chuck unit – Substrate size : Piece, 2inch, 4inch – Chuck cooling by Chiller – Substrate back side He cooling – System shielded perfectly from RF noise – Mechanical wafer chucking with clamp Power Supply Module RF generator (1ea) – for bias – Output power : 600W – Frequency : 13.56MHz – DC self bias display RF matching network (1ea) – Automatic matching type – Frequency : 13.56MHz l RF generator (1ea) – for ICP source – Output power : 1,000W – Frequency : 13.56MHz RF matching network (1ea) – Automatic matching type – Frequency : 13.56MHz RF cable kit (2set) Vacuum pump – TMP : 1,400 L/sec, Magnetic type – Rotary pump : 740L/min – Ultimate pressure : < 5×10-6 Torr Pressure gauge – Full range vacuum gauge : 760 torr ~ 5 x 10-9 torr – Pressure readout & cable kit l Pressure control – APC (Automatic Pressure Controller) – Pendulum valve – Baratron gauge : Full scale 0.1Torr Vacuum valves & lines – Fore line valve : Pneumatic type angle valve – Roughing line valve : Pneumatic type angle valve – Stainless steel hard line and flexible bellows line
Inductively Coupled Plasma Etching (ICP) ICP etching is a widely used technique to deliver high etch rates, high selectivity and low damage processing. Excellent profile control is also provided as the plasma can be maintained at low pressures.
- Manufacturer
- ULTECH
- Brand
- ULTECH
- Model
- PERI-150
- Year Manufactured
- 2019
- Year Procured
- 2018
- Department
- INSTITUT PENYELIDIKAN DAN TEKNOLOGI NANO OPTOELEKTRONIK (INOR)
- Location
- Blok A > Aras Bawah > Makmal Fabrikasi
- Date Registered LESIS
- 09/02/2024
- Category
- Research Equipment
- Function
- Category
- Staff operated
- Equipment Status
- Maintenance
Person In-Charge



